
|
Архитектура Аудит Военная наука Иностранные языки Медицина Металлургия Метрология Образование Политология Производство Психология Стандартизация Технологии |

|
Архитектура Аудит Военная наука Иностранные языки Медицина Металлургия Метрология Образование Политология Производство Психология Стандартизация Технологии |
МЕТОДИЧЕСКИЕ МАТЕРИАЛЫ ПО КУРСУСтр 1 из 11Следующая ⇒
МЕТОДИЧЕСКИЕ МАТЕРИАЛЫ ПО КУРСУ ″ВВЕДЕНИЕ В СПЕЦИАЛЬНОСТЬ″
ВВЕДЕНИЕ Наиболее характерные полупроводники - широкий класс веществ, характеризующийся значениями удельной электропроводности промежуточной между электропроводностями металлов (108...106) Ом–1м–1 и диэлектриков (108...10–16) Ом–1м–1. Характерной особенностью полупроводников, отличающей их от металлов, является возрастание электропроводности с ростом температуры за счет изменения концентрации свободных носителей заряда и их подвижности в объеме материала. Для полупроводниковых материалов характерна высокая чувствительность электропроводности к внешним воздействиям (световому и радиационному облучению, электрическим и магнитным полям), к содержанию примесей, дефектам структуры и т.п. В то же время различие между полупроводниками и диэлектриками, электропроводность которых также существенна при высоких температурах, скорее количественное, чем качественное. Термин полупроводники обычно понимают в узком смысле, т.е. как совокупность нескольких наиболее типичных групп веществ, полупроводниковые свойства которых проявляются уже при комнатных температурах (таблица 1). Таблица 1 Элементы,
Полупроводники (таблица 1.1.) представлены в виде ″чистых″ элементов (A, В) или в виде соединений, условно называемых AxBy. Цифрами отмечены значения важнейшего параметра полупроводниковых материалов – ширины запрещенной зоны (эВ) (см. далее). 1. Элементы IY группы Периодической системы - германий (Ge) и кремний (Si) Атомы этих элементов, имея четыре валентных электрона, образуют кристаллическую решетку типа ″алмаз″ с ковалентной связью. Собственно углерод с решеткой типа ″алмаз″ также обладает полупроводниковыми свойствами, однако величина ширины энергии запрещенной зоны у него значительно больше, чем у германия и кремния, поэтому при комнатных температурах проводимость алмаза мала. 2.Алмазоподобные полупроводники а) C оединения типа A III BV - cоединения элементов III группы (Al, Ga, In) с элементами V группы (P, As, Sb) -, например, GaAs, InSb, GaP, InP и т.п. Атомы Ш группы имеют по три валентных электрона, а атомы V группы - по пять, таким образом, в соединении типа AIIIBV среднее число валентных электронов, приходящихся на один атом - четыре. В результате соединения элементов Ш и V групп образуется кристаллическая решетка типа алмаза, аналогично, например, германию, с той разницей, что ближайшими соседями атома АIII являются атомы ВV, и наоборот. За счет частичного перераспределения электронов, атомы А и В в такой структуре оказываются разноименно заряженными. Поэтому связи в кристаллах АIIIВV частично ковалентные, частично - ионные. Однако ковалентная связь в них преобладает и определяет их структуру, в результате чего данные кристаллы по многим свойствам являются аналогами Ge и Si. б) Соединения типа А II ВVI - соединения элементов II и VI групп. К ним относятся соединения типа ZnTe, ZnSe, CdTe, CdS и другие. В этих соединениях на один атом также в среднем приходится по четыре валентных электрона, но ионная связь в них более выражена. ГЛАВА II . ОБРАЗОВАНИЕ НОСИТЕЛЕЙ ЗАРЯДА В МЕТАЛЛАХ И ПОЛУПРОВОДНИКАХ Введение Известно, что атомы состоят из ядра (нейтроны и протоны) и оболочки, состоящей из электронов, связанных с атомным ядром. В связи с этим данные электроны, называемые связанными, не могут участвовать в процессе электропроводности, т.е. переносить заряд, например, под действием электрического поля. Электрический ток может протекать только в том случае, когда в материале имеются свободные носители заряда (как положительного, так и отрицательного знака), оторванные от конкретных атомов. Для оценки параметров электропроводности материалов необходимо провести анализ возможности накопления в материале свободных носителей заряда Образование носителей заряда в металлах Металлы представляют собой кристаллическую решетку, в узлах которой находятся ионы, например, меди, железа, алюминия и т.п. Узлы связаны между собой металлической связью. В процессе формирования кристаллы атом, например, меди, ионизуясь, превращается в положительный ион меди С u+, закрепленный в узле, а ионизированный электрон (один от одного атома) выходит в пространство между узлами, формируя так называемый электронный газ (рис. 2.3, а). Очевидно, что перемещаться в пространстве может только оторвавшийся от атома электрон, который в данном случае называется свободным электроном. Совокупность свободных электронов, образующих электронный газ, совершает хаотическое тепловое движение (тепловая скорость до 105 м/с). При наложении электрического поля все свободные электроны начинают смещаться (к ″+″ полюсу источника) с небольшой дрейфовой скоростью (дрейфовая скорость до нескольких см/с). Ион металла, закрепленный в узле, имеет возможность только колебаться, формируя описанные выше колебания решетки, т.е. создавая фононы.
Рис. 2.3. Кристаллическая решетка (а) и зависимость концентрации (б) металла от температуры С учетом вышесказанного можно полагать, что в металлах свободные электроны присутствуют при температурах, вплоть до Т = 0 К, поэтому при любых температурах металлы могут проводить электрический ток. Концентрация n (м–3) свободных электронов в металлах (например, в меди n = 1028 м–3) определяется плотностью ионов и практически не зависит от температуры (рис. 2.3): n(T) = const. (2.1) Образование носителей заряда в полупроводниках Наиболее распространенные полупроводники: германий (Ge) и кремний (Si) относятся к элементам IY группы, т.е. имеют валентностью 4. Эти материалы - кристаллические тела, в узлах решетки которых находятся нейтральные атомы. При Т = 0 К свободных носителей заряда в полупроводниках нет, и поэтому электрическая проводимость материала отсутствует. Собственные полупроводники Собственными полупроводниками называются технологически очищенные полупроводниковые материалы, у которых содержание примесей минимально. Рассмотрим процесс образования свободных носителей заряда в собственных полупроводниках, за счет которых может реализоваться процесс проводимости полупроводников. На рис. 2.4, а-в показана упрощенная структура кристаллической решетки кремния, где ковалентные связи, образованные валентными электронами, обозначены двойными линиями.
Рис. 2.4. Реальный процесс образования носителей заряда (а, б, в) в полупроводнике В собственных полупроводниках собственные носители заряда - электроны образуются за счет процесса генерации (термогенерации) - отрыва валентных электронов от узла при Т > 0 K (рис. 2.4, а, переход I). Вероятность ионизации возрастает с ростом температуры. Следует учитывать, что при ионизации собственных атомов в узлах кристаллической решетки накапливаются неподвижные положительные ионы из-за образования разорванной химической связи (²ухода² электронов). Однако эти положительные ионы могут захватить электрон от соседнего атома (переход Y), превратившись в нейтральный атом, но фактически ион ²переместится² в другую область кристалла. Подобный процесс перемещения электронов от одного атома к другому отождествляется со свободным подвижным положительным зарядом – дыркой, способной перемещаться по кристаллу. Очевидно, что концентрация свободных электронов ni равна концентрации собственных дырок pi. В частности, при комнатной температуре (Т = 300 К) концентрация собственных носителей заряда в германии равна примерно ni = pi = 1019 м-3, кремнии - ni = pi= 1016 м-3, т.е. концентрация собственных носителей в германии на три порядка выше. Заметим, что при комнатных температурах электропроводность собственных полупроводников относительно мала за счет малой концентрации собственных носителей заряда. На основе квантовой теории полупроводников, связывающей их электрические, оптические и другие свойства с энергией, скоростью, концентрацией носителей заряда, создана зонная теория полупроводников - теоретическая модель, энергетически описывающая подобную взаимосвязь. В терминах зонной теории говорится, что подвижные носители заряда (электроны и дырки) могут находиться на определенных (разрешенных квантовой механикой) энергетических уровнях, совокупность которых образует разрешенные и запрещенные зоны энергий. Другими словами, реально электроны и дырки в процессе своего передвижения по кристаллу могут иметь лишь определенные значения энергии, а значит, и скорости. Поведение носителей заряда, и, соответственно, электрофизические свойства полупроводников, описываются графиком зависимости энергии Е(X) носителей (как свободных, так и связанных) заряда от координаты Х вдоль кристалла. Подобные графики, обычно называемые ²зонными диаграммами², изображены на рис. 2.4, г-е. На оси энергий выделяются три диапазона, отделяемых друг от друга значениями: Ев – ²потолок валентной зоны²; Епр - ²дно зона проводимости². Валентная зона энергий (далее, просто: валентная зона, ВЗ) - диапазон значений энергий (Е < Ев), которыми характеризуются, с одной стороны, электроны, связанные с узлами собственных атомов. Эти электроны называются связанными носителями заряда, их энергия возрастает ²вверх². С другой стороны, подобным диапазоном энергии характеризуются дырки, как свободные носители заряда, образованные в результате ухода электронов из валентной зоны в результате термогенерации (рис. 2.4, г, переход I). Энергия свободных дырок возрастает ²вниз² (переход Y). Зона проводимости (ЗП) – диапазон значений энергий (Е > Епр), которыми обладают свободные электроны - носители заряда, появившиеся в процессе процесса генерации. Запрещенная зона энергий (далее, просто: запрещенная зона, ЗЗ) - диапазон энергий (Епр > Е > Ев), которые запрещены (квантовой теорией). Другими словами, в полупроводнике нет свободных носителей заряда с энергиями в диапазоне Епр > Е > Ев. Согласно зонной теории, в процессе генерации собственных носителей заряда (рис. 2.4, а, г, переход I) для перехода электрона из валентной зоны в зону проводимости требуется сообщить электрону энергию, большую, чем DEз. Ширина запрещенной зоны, равная DEз = Епр - Ев, (2.2) у германия (Ge) - 0,72 эВ, у кремния (Si) - 1,12 эВ (таблица 2.1). Таблица 2.1. Ширина запрещенной зоны различных материалов Полупроводники |
Диэлектрики | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| Материал | DEз, эВ | Материал | DEз, эВ | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| Германий Ge | 0,72 | Алмаз | 5.2 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| Кремний Si | 1,12 | Окись алюминия | 7,0 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| Арсенид галлия GaAr | 1,43 | Нитрид бора | 4,6 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
| Специальные окислы | 0,1…0,3 | |||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||||
Полупроводники характеризуются относительно небольшой шириной запрещенной зоны DEз = 0,3 …1,5 эВ, диэлектрики - DEз > 3 эВ (таблица 2.1).
С точки зрения зонной теории процесс образования пары электрон-дырка (термогенерация собственных носителей заряда, рис. 2.4, переход I) описывается следующим образом. По мере увеличения температуры возрастает вероятность генерации собственных носителей заряда (пары электрон-дырка), т.к. электроны получают энергию, достаточную, чтобы преодолеть запрещенную зону и перейти из валентной зоны в зону проводимости (переход I). В терминах зонной теории говорится, что при уходе электрона из валентной зоны в ней появляется дырка. В реальности следует учитывать, что в нормальном (не возбужденном) состоянии атом электрически нейтрален, поэтому уход одного электрона приводит к тому, что узел (атом) приобретает положительный заряд. Данное вакантное место (в химической связи узла) может ²передвигаться² – так образуется и передвигается дырка как свободный носитель заряда. Вероятность образования свободных носителей заряда увеличивается по мере уменьшения ширины запрещенной зоны DEз.
Таким образом, в кристалле возможно независимое друг от друга перемещение, как свободных электронов (отрицательных зарядов), так и дырок (положительных зарядов).
Одновременно с процессом генерации носителей заряда протекает процесс их рекомбинации (рис. 2.4, г, переход IY). Реально это - захват электронов собственными ионизированными атомами германия или кремния (²встреча² электронов с дырками). В терминах зонной диаграммы процесс рекомбинации отождествляется с ²возвратом² электрона из зоны проводимости в валентную зону. В результате подобного процесса электронно-дырочная пара исчезает, но выделяется энергия, величиной не менее значения ширины запрещенной зоны. Рекомбинация может быть фононной, в результате чего полупроводник нагревается, или фотонной, в процессе которой происходим образование квантов света (см. светодиоды).
Среднее время между моментами генерации и рекомбинации называется временем жизни t носителей заряда. За счет рекомбинации концентрация свободных носителей зарядов может уменьшаться. При стационарных условиях и постоянной температуре благодаря непрерывной тепловой генерации и рекомбинации концентрация свободных носителей заряда в полупроводнике остается постоянной.
Итак, по мере увеличения температуры и возрастания вероятности тепловой генерации концентрация свободных носителей, а значит, и электропроводность возрастают экспоненциально.
Количественно зависимость концентрации свободных носителей заряда в собственных полупроводниках от температуры описывается выражением:
ni(T) = pi(T) = (NcNv)1/2e(–DEз/2kT) , (2.3)
где k = постоянная Больцмана (k = 1,38·10–23 Дж/К =8,6·10–5 эВ/К), T – абсолютная температура (К); Nc и Nv – постоянные (таблица 2.2).
Постоянные Nc и Nv определяется типом полупроводника и так называемой эффективной массой электрона mn и дырки mp в материале (таблица 2.2), не равные массе свободного электрона m е:
Nc(T) = (2/h3)(2pmnkT)3/2; (2.4)
Nv(T) = (2/h3)(2pmpkT)3/2; (2.5)
Значения параметров и концентрации собственных носителей при комнатной температуре в германии и кремнии приведены в таблице 2.2.
Таблица 2.2.
Параметры полупроводников при Т = 300 К
| Элемент | Параметр | ||||
| mn | mp | Nc, м–3 | Nv, м–3 | ni=pi, м–3 | |
| Германий | 0,55me | 0,39me | 1·1025 | 0,6·1025 | 2,5·1019 |
| Кремний | 1,05me | 0,56me | 2,8·1025 | 1,0·1025 | 1,5·1016 |
Поскольку ширина запрещенной зоны у германия меньше, чем у кремния, то в соответствии с соотношением (2.3) возрастание концентрации свободных собственных носителей в германии по мере увеличения температуры происходит интенсивнее (рис. 2.5) и уже при комнатной температуре на 3 порядка превышает концентрацию собственных носителей в кремнии.
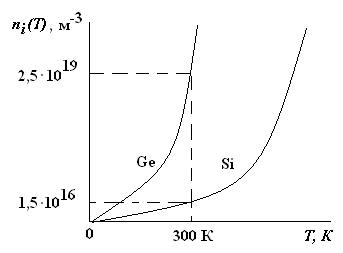
Рис. 2.5. Зависимости концентрации собственных носителей в германии и кремнии от температуры
При температурах, превышающих температурных диапазон эксплуатации полупроводниковых материалов (более 100…200 оС) концентрация собственных носителей приближается к значениям концентрации носителей в металлах.
Закон действующих масс
Как отмечено выше, в примесных полупроводниках (n- или p-типа) концентрация основных носителей заряда (nn в электронном полупроводнике, pp в дырочном полупроводнике) при температурах менее Т i обеспечивается ионизацией внедренной примеси.
Появление неосновных носителей заряда (pn, np – соответственно электронного и дырочного полупроводников) связано с термогенерацией (рис. 2.4), приводящей к ионизации собственных атомов, например, германия или кремния.
Обычно концентрация основных носителей на два-три порядка и более превышает концентрацию неосновных носителей заряда.
Концентрация основных носителей в различных полупроводниках количественно определяется выражениями (2.3), (2.7), (2.9), (2.11).
Концентрация неосновных носителей заряда может быть оценена на основе закона действующих масс, который формулируется следующим образом: при данной температуре произведение концентраций основных и неосновных носителей заряда является постоянной величиной, равной квадрату концентрации собственных носителей заряда в данном полупроводнике:
nnpn = ppnp = pi ni = ni 2(Т) = A2e-ΔЕз/kT =A2e хр(-ΔЕз/kT), (2.14)
где А – коэффициент.
Этот закон позволяет оценивать взаимосвязь концентраций основных и неосновных носителей заряда с концентрацией примесных центров в полупроводнике.
Анализируя свойства полупроводниковых материалов, следует обратить внимание на тот факт, что по мере увеличения температуры полупроводника, значение ni(Т), характеризующее концентрацию собственных свободных носителей заряда, экспоненциально возрастает (рис. 2.5; рис. 2.6; пунктирная кривая).
Рассмотрим особенность изменения концентрации носителей в диапазоне температуры Ts < T < Ti на участке II (рис. 2.6), характерном для материалов, выбираемых для таких устройств, как диоды, транзисторы, в том числе для интегральных микросхем.
Значения ni(Т), определяемые соотношением (2.3), необходимо учитывать при оценке концентраций неосновных носителей заряда в любом примесном полупроводнике.
Оценим значение концентрации основных и неосновных носителей заряда, например, в донорном полупроводнике при Т = 300 К (27 оС) и Nд = 1020 м-3. Поскольку Ti > T = 300 К > Ts, то мы находимся на участке II (рис. 2.6, точка 1), для которого характерна полная ионизация (истощение) донорных примесей, т.е. nn(300) = NД = 1020 м-3. Учитывая значение ni при комнатной температуре для кремния и германия, имеем, что при комнатной температуре в германии ni2 » 1038 м-6, в кремнии - ni2 » 1032 м-6. С учетом закона действующих масс (2.14) получаем, что концентрация неосновных носителей заряда - дырок равна pn = 1032/1020 = 1012 м-3 (в кремнии) и pn = 1038/1020 = 1018 м-3 (в германии).
Анализируя закон действующих масс можно сделать ряд важных выводов, которые будут использованы в дальнейшем:
1) в диапазоне рабочих температур (рис. 2.6, участок II, в области 20-60 оС) по мере увеличения степени легирования (роста концентрации атомов примеси NА или NД) концентрация основных носителей в полупроводниках возрастает, а неосновных (при той же температуре) - падает;
2) при одинаковой степени легирования (одинаковое количество примесей NА или NД) кристаллов Ge и Si при комнатной температуре концентрация основных носителей в этих примесных полупроводниках - одинаковая, однако, концентрация неосновных носителей в германии больше, чем в кремнии;
3) по мере роста температуры и, следовательно, возрастания ni(T), экспоненциально возрастает концентрация неосновных носителей заряда, поскольку на участке II (рис. 2.6) концентрация основных носителей постоянна. Этот факт негативно влияет на работу приборов, в частности, из-за возрастания тепловых токов в диодах и транзисторах (см. ниже).
В ведение
Электрический ток – поток направленного движения свободных носителей заряда в полупроводнике.
Как отмечено ранее, в кристаллах могут быть свободные носители заряда которые хаотически двигаются за счет теплового движения; подобное движение не создает электрический ток.
Направленное движение носителей в металле или полупроводнике возникает за счет нескольких факторов:
– дрейфовое движение носителей под действием электрического поля (за счет разности потенциалов на границах кристалла);
– диффузионное движение носителей из-за разницы концентраций зарядов в различных частях полупроводника.
Величина тока I (A) зависит от различных факторов. В частности, в зависимости от концентрации введенной примеси удельная проводимость примесного полупроводника, как параметр материала, возрастает по сравнению с собственным полупроводником в десятки и сотни тысяч раз.
Приложим к образцу (рис. 3.1, а) длиной l постоянное напряжение U. В образце возникнет электрическое поле напряженностью:
E = U/l. (3.1)

Рис. 3.1. Образец кристалла с приложенным напряжением и его ВАХ
Вектор напряженности Е направлен от ″+″ к ″–″. Под действием сил электрического поля электроны и дырки, двигаясь в различных направлениях, приобретают дрейфовую скорость vдр:
vдрn = mn E, vдрр = mp E, (3.2)
где mn, mp - значения подвижности электронов и дырок, м2/Вс.
Подвижность носителей m связывает дрейфовую скорость vдр с напряженностью электрического поля Е. Если температура неизменна, и, например, значение Е = 1 В/м, то величина дрейфовой скорости vдр численно равна vдр = m. При возрастании Е, например, в два раза, скорость vдр также увеличится в два раза. Однако, если при фиксированном значении Е изменять температуру образца, то скорость vдр будет зависеть от того, как изменяется подвижность от температуры или условий эксплуатации.
Вследствие направленного дрейфового движения в образце возникает электрический ток величиной I (А), причем выполняется закон Ома в виде:
I = U/R = US/rl, (3.3)
где U – напряжение, В; R – статическое сопротивление, Ом; S - сечение проводника, м2.
Плотность тока j(А/м2) определяется:
j = I/S , (3.4)
где S - сечение проводника.
Плотность тока j в образце, например, в форме параллелепипеда (рис. 3.1) равна
j = I/S = U/RS = U/rl = gU/l = gE, (3.5)
где U – напряжение на образце; R - сопротивление; S - сечение проводника, r и g - удельное электрическое сопротивление и электропроводность материала.
Выражение (3.5) в форме
j = gE (3.6)
представляет собой закон Ома в дифференциальной форме.
Поскольку, например, в полупроводнике имеются свободные носители двух знаков, то с учетом (3.2) и (3.3) плотность тока в полупроводнике равна:
j = gE = en vдрn + ep vдрр = (enmn + epmp)E = (gn + gp)E . (3.7)
Выражение (3.7) представляет собой закон Ома в дифференциальной форме, связывающий плотность тока j с внутренними параметрами n, p, v n, v р и напряженностью поля E в конкретной точке образца.
Величины r и g зависят от микропараметров кристалла, в частности, от концентрации носителей заряда n или р.
Согласно дифференциальному закону Ома проводимость g (Ом–1м–1) может иметь электронную (gn) и дырочную (gp) составляющие:
gn = enmn; gp = epmp. (3.8)
Заметим, что при фиксированной температуре и отсутствии взаимосвязи между напряженностью электрического поля Е, концентрациями n, p, а также подвижностями mn, mр из выражений (3.1) – (3.8) следует, что вольтамперная характеристика I(U) полупроводника представляется прямой линией с наклоном
r = dU/dI = const, (3.9)
где r - дифференциальное сопротивление.
Статическое сопротивление R, равное
R = U/I, (3.10)
не зависит от напряжения (рис. 3.1, б).
Проводимость металлов
Как указано выше, в металлах присутствуют только носители одного знака, а именно, электроны, образующие электронный газ.
Концентрация носителей (электронов) в металле практически не зависит от температуры и примерно равна концентрации ионов в узлах кристаллической решетки (рис. 2.1). Следовательно, с учетом сказанного, соотношение (3.4) может быть записано в виде:
j = gE = en vдрn = enmn E = gмE. (3.11)
Анализ (3.4) показывает, что зависимость проводимости gм металла, например, от температуры полностью определяется характером изменения подвижности mn электронов в металле от температуры.
Качественно, зависимость подвижности mn электронов в металле от температуры приведена на рис. 3.2, а.
В чистых металлах, не содержащих примесей, электронный газ при передвижении испытывает столкновение с узлами кристаллической решетки - положительными ионами (рис. 3.2, б). Сталкиваясь с колеблющимися узлами, электрон изменяет свое направление – рассеивается, при этом проекция его дрейфовой скорости на первоначальное направление уменьшается (электрон, как бы тормозится). Говорят, что происходит рассеяние электронов на узлах решетки, или с точки зрения квантовой механики - рассеяние электронов на фононах решетки.

Рис. 3.2. Зависимости подвижности, проводимости и удельного сопротивления
металла от температуры
Изменение температуры Т влияет на скорость передвижения носителей, и, следовательно, на их подвижность при фиксированном значении Е следующим образом (рис. 3.2, а). При очень низких температурах (участок I) электроны передвигаются между узлами кристалла, не испытывая столкновений, т.е. не рассеиваются, поскольку узлы решетки практически неподвижны относительно положения равновесия, следовательно, подвижность остается постоянной.
Увеличение температуры кристалла приводит к резкому возрастанию числа и амплитуды колеблющихся ионов (возрастает количество и энергия фононов решетки). При фиксированном значении Е движение электронов резко замедляется с ростом температуры, причем подвижность пропорциональна Т–5 0(участок П). При дальнейшем увеличении температуры количество фононов остается постоянным, однако их энергия возрастает (участок Ш), так что рассеяние продолжает возрастать, но в этом диапазоне температур подвижность пропорциональна T–1.
Заметим, что внедрение в чистый металл примесей или образование дефектов кристаллической решетки в целом уменьшает подвижность носителей по сравнению с подвижностью в чистом металле, поскольку появляется дополнительный механизм рассеяния – столкновение с примесными центрами.
Учитывая взаимосвязь проводимости g с подвижностью и концентрацией носителей по соотношению (3.4), легко понять, что зависимость проводимости gм(T) (рис. 3.2, в) идентична зависимости m(T) (рис. 3.2, а).
Наконец, с учетом того, что удельное электрическое сопротивление r (Омм) обратно значению проводимости
r = 1/g, (3.12)
получаем (рис. 3.2, г), что на участке II удельное электрическое сопротивление r ~ Т 5, а на участке III - r ~ Т 1.
Следует отметить, что диапазон естественных температур (0 …100 оС), характерных для эксплуатации металлических проводников находится в на участке III; именно поэтому при оценке удельного сопротивления r(t) металлов обычно используется соотношение типа:
r(t) = r20(1 + aDt), (3.13)
где r20 – табличное значение удельного сопротивления при t = 20 оС; Dt – превышение температуры выше 20 оС; a - температурный коэффициент удельного электрического сопротивления TKr (табличное значение для отдельного материала), определяемый как
a = TKr = (1/r)dr/dt . (3.14)
Учитывая, что при увеличении температуры сопротивление металлов растет (a > 0), терморезисторы на основе металлов относятся к позисторам (см. далее).
Варисторы
Варистор - нелинейный резистор, сопротивление которого зависит от напряженности электрического поля. Можно сказать, что в аристор (переменный резистор) – полупроводниковый прибор, сопротивление которого изменяется по мере увеличения приложенного напряжения.
Варисторы изготавливают, используя метод керамической технологии, который заключается в следующем. Основой для изготовления варисторов являются так называемые полупроводники группы AIYBIY, единственным представителем этой группы является соединение элементов IY группы – карбид кремния (SiC). Кристаллический материал размельчают, смешивают со стеклообразующей основой (глина, жидкое стекло, органические лаки и другие), после чего порошкообразный карбид кремния запрессовывают вместе со связующим веществом в форму (цилиндра или таблетки) и спекают при температуре 1700 оС. Более детальные сведения по технологии изготовления варисторов изложены в литературе.
Ширина запрещенной зоны DEз, определяющая собственную проводимость для различных модификаций кристаллического карбида кремния, изменяется от 3 до 6 эВ. Однако, поскольку в материале может быть значительное количество как донорных, так и акцепторных примесей, их энергия активации DEпр изменяется в широких пределах до нескольких десятых эВ. Поэтому примесная проводимость в материале осуществляется до температур 600 оС, после чего реализуется собственная проводимость.
В целом, композиционную структуру материала можно представить как совокупность микроскопических монокристаллов карбида кремния (размером зерен от 40 до 300 мкм), поверхностно разделенных между собой, с одной стороны, тонкими слоями окисных пленок (рис. 4.2, а), с другой стороны, многократно соприкасающихся между собой посредством точечных микроконтактов, условно представленных на рис. 4.2, б.
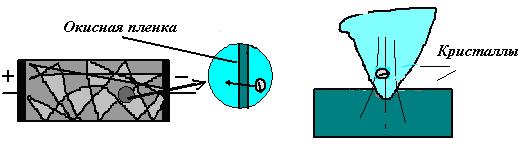
а) б)
Рис. 4.2. Совокупность кристаллов (а) и точечные контакты (б) в структуре варистора
По мере увеличения напряжения на варисторе ток растет нелинейно независимо от полярности напряжения (рис. 4.3, линия 1). Причиной нелинейного возрастания тока является резкое снижение сопротивления материала (линия 2).
Процессы, протекающие в варисторе, описываются моделями прохождения носителей:
а) через диэлектрические пленки, например, SiO2, возникающие на границе отдельных зерен (рис. 4.2, а), т. е. проникновения электрических зарядов через поверхностные потенциальные барьеры на границах этих зернами;
б) через точечные контакты между микрокристаллами (рис. 4.2, б);
в) через всевозможные p - n-переходы, обусловленные различной электропроводностью примыкающих друг к другу контактных областей.

а) б)
Рис. 4.3. Вольтамперная характеристика варистора и его подключение в цепь
Рассмотрим эти процессы более подробно. Несмотря на то, что поверхностные диэлектрические пленки имеют малую толщину, они характеризуются большим сопротивлением, и на каждой из них падает напряжение DUi. Значит, в этих пленках возникают сильные электрические поля напряженностью E даже при малых напряжениях на варисторе. Фактически напряжение, приложенное к образцу, падает не в объеме микрокристаллов карбида кремния, а в изоляционных диэлектрических пленках.
Проводимость отмеченных диэлектрических пленок реализуется, главным образом, посредством туннельного эффекта (туннелирования) - квантового эффекта, в котором проявляются волновые свойства электронов. Высокие электрические поля приводят к нелинейному возрастанию вероятности туннелирования носителей заряда сквозь энергетические потенциальные барьеры тонких оксидных пленок, вследствие чего происходит резкое увеличение проводимости кристаллов карбида кремния. Именно этим обусловлен начальный участок вольтамперной характеристики (рис. 4.3, а) при малых напряжениях на варисторе, характеризуемый относительно малыми токами и большими значениями сопротивления постоянному току.
При дальнейшем увеличении напряжения на варисторе токи нелинейно возрастают; в этом диапазоне напряжений начинают играть роль точечные контакты между зернами, условно изображенные на рис. 4.2, б. При относительно больших токах, проходящих через варистор, плотность тока в точечных контактах оказывается очень большой. Сопротивление контактов больше, чем сопротивление объема, поэтому на контактах падает практически все подведенное к прибору напряжение, и вследствие этого именно в области контактов происходит интенсивный разогрев за счет выделяемого джоулевского тепла. Удельная мощность, выделяемая в точечных контактах, достигает больших значений. Из-за выделения тепловой (джоулевской) энергии и локального разогрева микроконтактов их проводимость (как полупроводниковых структур) увеличивается, и сопротивление варистора, в целом, нелинейно уменьшается.
Варисторы, как нелинейные резисторы, используются в низковольтных и высоковольтных электрических цепях (постоянного и переменного тока) для регулирования силы тока в зависимости от напряжения, а также для защиты цепей, в частности, линий электропередач, от перенапряжений. Описание и применение нелинейных резисторов (на основе материала вилита или тирита в вентильных разрядниках высоковольтных линий электропередач, для защиты электрических цепей, в вилитовых стержнях) приведено в рекомендованной литературе.
В частности, для защиты сопротивления нагрузки Rн от перенапряжения (рис. 4.3, б), например, при резком увеличении напряжения U, варистор включается параллельно.
К параметрам варистора относятся:
- вольтамперная характеристика (ВАХ);
- коэффициент нелинейности варистора b(U) - отношение статического R и дифференциального rd сопротивлений при заданном постоянном напряжении на варисторе:
b(U) = R/rd = (U/I)/(dU/dI). (4.4)
В форме конечных разностей имеем
b = (U/I)×DI/DU. (4.5)
- температурные коэффициенты статического сопротивления:
при постоянном напряжении:
ТКR|U=const = (1/R) (dR/dT)|U=const; (4.6)
при постоянном токе:
ТКR|I=const = (1/R) (dR/dT)|I=const. (4.7)
- другие параметры и характеристики.
Эффект Ганна. Диод Ганна
Эффектом Ганна называется явление возникновения высокочастотных колебаний тока в образце, к которому приложено постоянное напряжение. При этом характерным является образование на вольтамперной характеристике полупроводника участка с отрицательным дифференциальным сопротивлением.
Рассмотрим предпосылки данного явления. Согласно дифференциальному закону Ома проводимость полупроводников определяется выражением (3.7). Под действием напряжения U в образце возникнет электрическое поле напряженностью E = U/l, так что электроны и дырки, двигаясь в различных направлениях, приобретают дрейфовую скорость vдр: vдрn = mn E, vдрр = mp E.
При этом ранее принималось, что величины концентрации носителей заряда и их подвижности не зависят от значения напряженности электрического поля. Однако, в сильных электрических полях (Е > 105 В/м) концентрации и подвижности носителей заряда зависят от напряженности электрического поля в широких пределах, так что при фиксированной температуре проводимость, плотность тока в целом являются нелинейной функцией от напряженности (напряжения):
g(Е) = en(Е)mn(Е) + ep(Е)mp(Е); (4.15)
j(Е) = g(Е)E = gn(Е)Е+ gp(Е)Е. (4.16)
Следует учитывать, что образование и перемещение носителей заряда в полупроводниках подчиняется квантово-механическим законам, выводы которых можно сформулировать следующим образом.
Во-первых, кристаллы полупроводников обладают ярко выраженными анизотропными свойствами, в частности, параметры проводимости, сопротивления, а значит, и токи через кристаллы, зависят от того, в каком направлении двигаются электроны и дырки.
Во-вторых, электроны и дырки, генерируемые под действием температуры, по ряду характеристик отличаются от свойств свободного электрона в вакууме, обладающего массой me. Поэтому в квантовой теории полупроводников вводятся понятия ²эффективные массы² электронов mn и дырок m р, определяемые как
mn = am е; m р = с m е, (4.17)
где a , с – известные коэффициенты, которые могут быть как больше, так и меньше единицы (см. таблицу 2.2).
В-третьих, в полупроводнике могут одновременно присутствовать совокупность быстрых n1 и медленных n2 носителей заряда, например, электронов, различающихся по эффективной массе mn1 < mn2, и, соответственно, по подвижности mn1 >mn2. Причиной подобного поведения электронов является их энергетическое взаимодействие с узлами реальной кристаллической решетки полупроводника.
Суммарная концентрация электронов равна n0, при этом часть электронов c концентрацией n1 обладает малой массой mn1, а другая (с концентрацией n2) - большой эффективной mn2 массой. Концентрации n0, n1, n2 могут быть рассчитаны методами квантовой статистики, в частности, расчеты показывают, что при фиксированной температуре всегда выполняется условие
n0 = n1 + n2, (4.18)
В частности, в кристалле GaAs (без приложенного напряжения) отношение подвижностей носителей mn1/mn2 = 40; эффективных масс электронов mn2/mn1 = 16.
Другими словами, в теории полупроводников вводится понятие ²тяжелых² и ²легких² электронов, различающихся не только по эффективной массе, подвижности, но и по концентрациям.
Наконец, теория показывает, что вероятность образования ²легких² или ²тяжелых² электронов, зависит от того, какую энергию получают электроны от приложенного электрического поля, т.е. от приложенного к образцу напряжения. При приобретении определенной энергии ²легкие² электроны, ускоренные в некотором пороговом поле напряженностью Eпор, становятся ²тяжелыми², и, в конечном счете, их скорость уменьшается.
Рассмотрим последствия изменения концентрации и подвижности носителей заряда от напряженности (напряжения), приводящие к эффекту Ганна, на примере кристалла арсенида галлия GaAs n-типа.
Имеем полупроводник GaAs в форме параллелепипеда сечением S, к которому приложено постоянное напряжение U (рис. 4.5, а). В образце длиной l (примерно 1-200 мкм) появляется электрическое поле со средней напряженностью
Еср = U/l. (4.19)

а) б)
Рис. 4.5. Кристалл GaAs (а) и его вольтамперная характеристика (б)
Увеличивая напряжение на кристалле, проанализируем зависимость плотности тока от напряжения j(U). Оказывается, характеристика плотности тока данного кристалла от напряжения имеет нелинейный характер (рис. 4.5, б), причем в области напряжений UB…U С возникает участок с так называемым отрицательным дифференциальным сопротивлением (ОДС), т.к. r = dU/dI < 0. Примечательным является то, что в области напряжений UB…U С в цепи возникают высокочастотные колебания тока (рис. 4.6, в).
Нелинейность характеристики, приводящая к эффекту Ганна, может быть объяснена следующим образом.
При отсутствии напряжения U = 0 (электрического поля нет) при естественных температурах в образце имеются электроны, обладающие как высоким, так и низким значениями подвижности. При выполнении условия (4.18) соблюдается: n2/n1 = 2,3×10-3, т.е. с учетом соотношения их концентраций (n1 >> n2), можно считать, что все электроны в малых полях обладают подвижностью m1 (практически все электроны - ²легкие²).

а) б) в)
Рис. 4.5. Распределение концентрации и электрического поля в образце
без доменов (а), с доменами (б), зависимость плотности тока от времени (в)
При приложении к полупроводнику электрического напряжения (²-² на катоде, ²+² на аноде) в объеме материала возникает электрическое поле напряженностью Е(U), возрастающей по мере увеличения напряжения, и через материал начинает протекать электрический ток с плотностью j(U).
Первоначально, зависимость плотности j (или силы тока I) от напряженности (или напряжения) может быть представлена кривой, изображенной на рис. 4.4, б, участок 0А. В слабых полях (Е < Eпор = U В/l) практически все электроны имеют скорость v1 = m1E, а проводимость и плотность тока равны
g(Е) = en1m1(Е); j(Е) = g(Е)Е; I(U) = j(Е)S. (4.20)
Другими словами, с учетом выражений (4.20) можно получить, что зависимость плотности тока от напряжения на различных участках (ВАХ) имеет наклон dj/dE = dI/dU ~ m, поэтому оказывается, что на участке 0А плотность тока j(U) ~ m1, а на участке С D - j(U) ~ m2.
По мере увеличения напряжения U, и, значит, напряженности электрического поля Е, возрастают дрейфовая скорость и энергия электронов, двигающихся от катода к аноду. По мере роста энергии электронов изменяются условия их энергетического взаимодействия с узлами кристаллической решетки, и в результате этого (при U > U В) увеличивается концентрация тяжелых электронов с меньшей подвижностью.
Все это приводит к тому, что как только напряжение на образце достигнет значений U > U В (рис. 4.5, б), плотность j(U) тока (ток) уменьшается по мере роста напряжения, но после напряжения U > UC наклон (dj/dU) характеристики изменяется, подтверждая, что j(U) ~ m2. С позиции квантовой механики это может быть объяснено тем, что в материале начинают доминировать электроны с меньшей подвижностью - ²тяжелые² электроны.
На участке II (рис. 4.5, б) значение плотности (или силы тока) уменьшается с ростом напряженности (или напряжения); подобная зависимость тока от напряжения называется N-образной вольтамперной характеристикой, а участок II - участок с отрицательным дифференциальным сопротивлением (участок ОДС).
Приборы, обладающие N-образной вольтамперной характеристикой, служат для генерации, усиления и преобразования электромагнитных колебаний.
В самом деле, в диоде Ганна, обладающем N-образной характеристикой, возникают колебаний тока, что может быть объяснено следующим образом.
Допустим (рис. 4.6, а), что в однородном кристалле n-типа длиной l первоначально имеется равновесная концентрация носителей заряда n0. По мере увеличения напряжения до величины U В в момент времени t0 (рис. 4.6, в) величина напряженности электрического поля Е в объеме материала достигла значения Епор. Значение плотности тока при этом (рис. 4.6, б, точка В) равно
jmax = en0m1E= en0v1. (4.21)
Оказывается, что состояние полупроводника в точке В является неустойчивым: за счет так называемых ²краевых эффектов² на границе полупроводникового материала (на контактах) значение напряженности Ек(0) и Ек(l) всегда должно быть больше, чем в объеме. Поэтому вблизи контактов (рис. 4.6, б, области 0 < X < l1 и l > X > l4) достигается значение Ек > Eпор. Заметим, что в силу того, что напряжение на кристалле постоянно и равно линейному интегралу от напряженности поля по длине полупроводника
 , (4.22)
, (4.22)
в диапазоне l1 < X < l4 величина напряженности Е V в объеме Е V < Епор. В самом деле, для того чтобы интеграл (напряжение) был постоянным при увеличении Ек, необходимо, чтобы в объеме значение Е V – уменьшалось.
Повышенное значение напряженности Ек > Eпор в локальной области (0< X < l1) полупроводника приводит к увеличению концентрации ²тяжелых² электронов за счет уменьшения концентрации ²легких².
В то же время пониженное значение напряженности Е V < Eпор собственно в области (l2 < X < l4) полупроводника оставляет концентрацию ²легких² электронов неизменной.
Обратим внимание на область полупроводника, примыкающую к катоду (0 < X < l2). В левой части этой области при 0 < X < l1 за счет повышенной напряженности поля вблизи катода возникают "тяжелые" электроны, которые начинают более медленно дрейфовать к аноду. В то же время, из правой части области с координатами (l1 < X < l2) продолжают уходить более быстрые электроны. Поскольку ²тяжелые² электроны, выходящие от катода, не успевают своевременно замещать уход быстрых электронов, то в объеме области с координатами l1 < X < l2 возрастает локализованный заряд нескомпенсированных положительных ионов доноров, которые ранее электрически компенсировались подходящими от катода ²легкими² электронами.
В связи с этим говорится, что в области катода образуется электрический ²домен², который состоит из двух разделенных слоев (²тяжелых² электронов и нескомпенсированных ионов доноров). Электрическое поле внутри домена Едом, достигающее в максимуме Eд, направлено так же, как и внешнее электрическое поле E. По мере формирования домена его электрическое поле Едом возрастает, но, соответственно, с учетом (4.22), за пределами домена напряженность поля уменьшается до величины EV, перераспределяясь по длине кристалла (рис. 4.5, б): чем больше значение Eд, тем меньше величина EV.
При выполнении условия (4.22) поле в образце перераспределяется по длине. Это приводит к тому, что скорость ²тяжелых² электронов внутри домена возрастает, а скорость "легких" электронов за пределами домена - уменьшается. В устанавливающемся равновесном состоянии скорость движения "тяжелых" электронов (vт) достигает значения скорости "легких" (vл), так что
vт = vл < v1, (4.23)
где v1 - скорость легких носителей в отсутствие образованного домена.
Очевидно, что скорость передвижения "тяжелых" электронов становится равной скорости перемещения домена (vд) в объеме образца. Другими словами, сформированный домен передвигается в образце со скоростью vдср.
После образования домена (промежуток времени t0…t1) и его движения через объем кристалла (промежуток времени t1…t2) плотность тока уменьшится и будет равна
jmin = en0m2EV = en0vдср < en0v1. (4.24)
В интервале времени t2…t3 домен достигает области анода и постепенно исчезает; плотность тока вновь возрастает, и электрическое поле в объеме материала достигает исходных значений. Далее процесс повторяется путем формирования нового домена на катоде.
С учетом вышесказанного, период Т возникающих колебаний плотности тока может быть охарактеризован средним временем пролета домена через длину полупроводника:
T = l/vдср. (4.25)
Очевидно, что частота колебаний тока будет определяться геометрией образца и свойствами полупроводникового материала, влияющими на скорость движения доменов:
f = 1/T= vдср/l. (4.26)
Полупроводниковые устройства, предназначенные для получения электрических колебаний на основе эффекта Ганна, называются генераторами Ганна (генераторными диодами или генераторами Ганна). Заметим, что несмотря на характерное название, диоды Ганна не содержат р-n-перехода, свойства которого рассмотрены ниже.
Диоды Ганна имеют обозначения, например, АА721, АА718, АА727. Основными параметрами являются: рабочие частоты (до 100-200 ГГц), постоянный рабочий ток (0,2-2 А), постоянное рабочее напряжение (10-80 В), мощность рассеивания (3-17 Вт).
Гальваномагнитные явления
Физические явления, возникающие в металлах и полупроводниках, находящихся в магнитном поле, и обусловленные прохождением через материал электрического тока под действием электрического поля, называются гальваномагнитными эффектами. К гальваномагнитным явлениям относятся эффект Холла, магниторезистивный эффект Гаусса, поперечный гальванотермомагнитный эффект (эффект Эттингсгаузена), продольный гальванотермомагнитный эффект (эффект Нернста).
Эффект Холла
Метод Холла служит качественным и количественным методом для определения многих параметров полупроводника.
Упрощенная схема для определения типа носителей по методу Холла приведена на рис. 4.6. Основным элементом схемы является датчик Холла - образец в форме параллелепипеда, у которого имеются токовые (1, 2) и холловские (3, 4) электроды.
Приложим к образцу постоянное напряжение Uп, которое обеспечивает протекание тока Iп через образец, например, по оси -Х. Пропуская ток Iк через обмотку катушки (соленоида), создадим магнитное поле, направление вектора индукции B которого зависит от направлений намотки провода и тока катушки Iк, связанных правилами правого винта или правой руки. В частности, с учетом направлений тока в катушке, характера расположения витков в соленоиде (рис. 4.6) вектор индукции В имеет направление по оси -Y.

Рис. 4.6. Упрощенная схема для исследования эффекта и датчика Холла
За счет источника постоянного напряжения Uп через образец протекает ток Iп, обусловленный дрейфовым движением основных носителей заряда.
Нашей задачей является определение типа основных носителей: электроны или дырки?
Допустим, что в образце имеются как электроны, так дырки в одинаковом количестве. Тогда с учетом выбранного направления тока Iп электроны за счет дрейфа (без магнитного поля) будут двигаться в направлении по оси +Х (к передней грани 1 образца), дырки - по оси -Х (к задней грани 2 образца).
При протекании тока Iк в катушке соленоида возникает индукция магнитного поля В, создающая силу Лоренца, действующую на движущиеся заряженные частицы. Направление этой силы может быть определено мнемонически по правилу левой руки с учетом следующей формулировки: если расположить левую руку так, чтобы силовые линии магнитного поля входили в ладонь, а вытянутые пальцы указывали направление тока, то большой палец указывает направление силы Лоренца.
Математически направление вектора F силы Лоренца может быть найдено из векторного произведения
 F = q[v B], (4.27)
F = q[v B], (4.27)
где v - вектор скорости дрейфового движения носителей; B - вектор индукции магнитного поля; q - заряд (с учетом знака) носителя.
Заметим, что в равновесии в объеме материала соблюдается электронейтральность: все положительные заряды (дырки, положительные ионы) скомпенсированы (равны) отрицательными зарядами (электроны, отрицательные ионы).
Подчеркнем, что сила Лоренца заставляет носители (как электроны, так и дырки) смещаться к одной из граней (в данном случае – к верхней грани 4). Следовательно, под действием силы Лоренца свободные носители (их знак нам неизвестен) накапливаются у холловского электрода 4. В то же время на противоположном холловском электроде 3 за счет ″ухода″ из этого объема носителей нарушается электронейтральность и возникает заряд другого знака, обусловленный нескомпенсированными заряженными ионами решетки - неподвижными зарядами ионов доноров или акцепторов.
В самом деле, если бы к верхнему электроду двигались только электроны, то вблизи нижнего электрода появлялся ″+″ заряд положительных ионов доноров. Если бы вверх смещались только дырки, то внизу накапливался ″–″ за счет отрицательного заряд ионов акцепторов.
Заметим, что при одновременном движении вверх электронов и дырок в собственном полупроводнике ЭДС Холла практически не возникает. Поэтому в датчиках Холла используются материалы с выраженным типом проводимости: n- или р-типа.
Как узнать, какие именно носители сместились вверх под действием силы Лоренца?
Для решения этого вопроса между электродами 3 и 4 устанавливается (рис. 4.6) чувствительный вольтметр (гальванометр), который регистрирует разность потенциалов (ЭДС Холла) UХ = j4 - j3, возникающую за счет разделения зарядов противоположного знака между холловскими электродами 4 и 3.
Известно, что положительная клемма измерительного прибора "+" находится справа, а клемма "-" - слева (рис. 4.6). Для удобства анализа "0" шкалы находится посередине. Зафиксировав отклонение стрелки прибора (по или против хода часовой стрелки), можно сделать вывод о знаке потенциала, подаваемого на конкретную клемму вольтметра, и, следовательно, о знаке свободных носителей заряда, накапливающихся у холловского электрода (в данном случае, у электрода 4).
В частности, при направлениях токов Iп и Iк, вектора индукции В, указанных на рис. 4.6, можно сделать вывод, что сила Лоренца направлена вверх (по оси +Z). Носители, знак которых необходимо определить, накапливаются у верхнего холловского электрода 4, который соединен с правой (положительной) клеммой вольтметра. Если, к примеру, стрелка отклонилась влево (рис. 1.9), то это однозначно означает, что на клемму "+" подан отрицательный потенциал (от электрода 4). Значит, можно сделать вывод: основные носители заряда в кристалле - электроны, и соответственно, неосновные - дырки.
Количественно концентрация носителей заряда и их подвижность могут быть определены с помощью схемы измерения, приведенной на рис. 4.6.
Допустим, что основные носители в датчике Холла – электроны с концентрацией nn, а концентрацией неосновных дырок пренебрегаем.
За счет разделения зарядов (например, вверху электроны, внизу – некомпенсированный заряд положительных ионов доноров) возникает электрическое поле - поле Холла - напряженностью ЕХ, направленное по оси Z. Это поле начинает перемещать электроны (заряд электрона e) по оси -Z с силой, равной еЕХ, но противоположной силе Лоренца.
В равновесии поле Холла компенсирует силу Лоренца
еЕХ = e vдрnB. (4.28)
Умножая обе части выражения (4.28) на высоту образца b, получаем, что разность потенциалов (ЭДС Холла) между верхним и нижним электродами UХ равна
UХ = EХb = vдрnBb. (4.29)
Учитывая взаимосвязь (3.7) между током Iп, плотностью тока jп в полупроводнике, концентрацией носителей заряда n и их дрейфовой скоростью vдрn получаем, что напряжение Холла равна
UХ = jпBb / enn = IпB / ennd, (4.30)
где b и d – высота и толщина образца, соответственно.
Подвижность mn и концентрация носителей nn заряда могут быть определены, если, например, из эксперимента известны значения напряжения Uп на образце длиной l, индукция В и напряжение Холла UХ.
В самом деле, с учетом (4.28) и (4.30), с одной стороны:
j = gE = en nmn E = en nmn Uп/l, (4.31)
с другой стороны:
j = I/S = I/bd, (4.32)
следовательно:
j = en nmn Uп/l = Iп/bd, (4.33)
откуда получаем
mn = Iпl/en n Uпbd = lUХ/bUпB, (4.34)
а также
nn = IпB/edUХ. (4.35)
Для практических целей используется коэффициент Холла Rn (или Rр), рассчитываемый по формулам:
Rn = 1/enn (или R р = 1/e р p), м3/Кл . (4.36)
Датчики Холла (преобразователи Холла), действие которых основано на эффекте Холла, получили широкое распространение. Они используются в схемах различных полупроводниковых приборов: магнитометров, преобразователей постоянного тока в переменный и наоборот, генераторов сигналов переменного тока, усилителей постоянного и переменного тока, фазометров, микрофонов, измерителей мощности, перемножителей и т.п.
Для примера, рассмотрим использование датчика Холла в множительном устройстве (МУ) в ЭВМ (рис. 4.7).

Рис. 4.7. Упрощенная схема холлотрона
Допустим, что необходимо перемножить значения двух токов I1 и I2, т.е. найти получить величину, равную или пропорциональную произведению двух аналоговых сигналов.
С учетом (4.34) датчик Холла характеризуется значением напряжения UХ (ЭДС Холла), равного
UХ = IпB / ennd =(Rn/d)IпB = kХIпB, (4.37)
где kХ - конструкционная постоянная.
Как видно из соотношения (4.37) величина UХ пропорциональна произведению тока Iп и индукции B.
Для того, чтобы использовать датчик Холла в множительном устройстве необходимо один из входных сигналов I1 сформировать в виде тока, проходящего через полупроводник, и считать, что I1 = Iп. Второй ток I2 необходимо ²пропускать² через обмотку катушки соленоида, тем самым, преобразуя энергию электрического тока I2 = Iк в энергию магнитного поля с индукцией В. Это возможно, потому что магнитная индукция, возникающая в катушке соленоида, пропорциональна току катушки Iк:
B = kкIк, (4.38)
где kк – коэффициент, зависящий от плотности витков w провода, магнитной проницаемости материала сердечника соленоида и т.п.
С учетом (4.37) и (4.38) имеем напряжение UХ на выходе датчика Холла:
UХ = kХkкIпIк = kIпIк, (4.39)
т.е. в схеме реализуется перемножение аналоговых величин – токов Iп и Iк.
На рис. 4.7 представлена упрощенная схема перемножителя на основе холлотрона, используемого благодаря двойной линейной зависимости (4.39) выходной ЭДС Холла от входного тока Iп и от индукции В магнитного поля. Учитывая относительно малую чувствительность датчика Холла (kХ ≈ 0,6…90 Тл×В/А), в реальных устройствах используются схемы усиления сигналов. Таким образом, на выходе усилителя получается выходное напряжение Uвых, пропорциональное произведению двух аналоговых сигналов - токов I1 и I2.
Эффект Эттингсгаузена
Допустим, что кристалл полупроводника имеет температуру Т. Эта температура характеризует ²усредненную² энергию свободных носителей заряда – электронов и дырок, называемую энергией Ферми Eф(Т).
Рассмотрим полупроводник n-типа, в котором можно пренебречь концентрацией дырок. Вся совокупность свободных электронов обладает разной энергией и скоростями; распределение электронов по скоростям подчиняется статистике Ферми-Дирака. Можно сказать, что часть ²горячих² электронов имеет энергию E > Eф, а часть ²холодных² электронов - энергию E < Eф. Учитывая взаимосвязь энергии электронов и их тепловой скорости
(Е = m vт2/2), очевидно, что ²горячие² и ²холодные² электроны двигаются с различными скоростями в кристалле.
В случае различных тепловых скоростей носителей равенство (4.28) будет справедливо не для всех электронов, а только для тех из них, которые движутся с некоторой средней скоростью vср. Для ²горячих² носителей, движущихся со скоростью vт > vср, значение силы Лоренца, равное qсрv B, больше силы, действующей за счет поля Холла: q vтB > q vcрB = qEХ. Вследствие этого быстрые носители, например, активно отклоняются силой Лоренца, как отмечено ранее, к грани 4 - вверх (рис. 4.5). ²Холодные² носители, имеющие меньшую скорость vт < vср, ²не в силах² преодолеть поле Холла EХ, и отбрасываются им к другой грани 3 пластины (вниз). Таким образом, поле Холла производит сепарацию (разделение) ²горячих (более быстрых) и ²холодных² (медленных) носителей заряда.
Быстрые носители, имеющие избыточную энергию, попадая на верхнюю грань пластины, сталкиваются с узлами решетки и отдают ей свой избыток энергии, нагревая грань 4. Медленные носители, напротив, увеличивают свою энергию, отбирая часть энергии от узлов, тем самым, охлаждая кристаллическую решетку у грани 3. Возникает эффект Эттингсгаузена, проявляющийся в образовании "поперечной" разности температур, причем
Т4 > Т > T3.
Эффект Нернста
Двигающиеся носители заряда массой m, попадающие в однородное поперечное магнитное поле с индукцией В, начинают закручиваться (вращаться) по круговой траектории с определенным радиусом r кривизны: чем больше скорость движения, тем больше сила Лоренца, и, соответственно, больше радиус кривизны r.
В самом деле:
F = m v2/r = e v B; (4.44)
r = m v/eB. (4.45)
Другими словами, быстрые носители закручиваются в магнитном поле по траектории с большим радиусом, чем медленные. Можно сказать, что траектория ²горячих² (быстрых) носителей - более прямолинейная.
Допустим, что в образце, изображенном на рис. 4.5, основные носители - электроны. Тогда движение электронов преимущественно будет осуществляться через объем образца от задней грани 2 к передней грани 1 (направление тока Iп указано на рисунке). Вследствие различного ²закручивания² электронов в магнитном поле задняя грань 2 будет обогащаться "возвращающимися" к ней медленными электронами и охлаждаться, т.к. ²холодные² медленные электроны забирают энергию от решетки со средней температурой Т. Передняя грань 1, напротив, будет нагреваться за счет подхода к ней быстрых (горячих) электронов. Возникает эффект Нернста, проявляющийся в образовании "продольной " разности температур, причем Т2 > Т > T1.
Рассмотренные гальванотермомагнитные эффекты используются при создании охлаждающих микроэлектронных устройств, с помощью которых достигается разность температур вплоть до 100 С.
МЕТОДИЧЕСКИЕ МАТЕРИАЛЫ ПО КУРСУ
″ВВЕДЕНИЕ В СПЕЦИАЛЬНОСТЬ″
ВВЕДЕНИЕ
Наиболее характерные полупроводники - широкий класс веществ, характеризующийся значениями удельной электропроводности промежуточной между электропроводностями металлов (108...106) Ом–1м–1 и диэлектриков (108...10–16) Ом–1м–1.
Характерной особенностью полупроводников, отличающей их от металлов, является возрастание электропроводности с ростом температуры за счет изменения концентрации свободных носителей заряда и их подвижности в объеме материала. Для полупроводниковых материалов характерна высокая чувствительность электропроводности к внешним воздействиям (световому и радиационному облучению, электрическим и магнитным полям), к содержанию примесей, дефектам структуры и т.п.
В то же время различие между полупроводниками и диэлектриками, электропроводность которых также существенна при высоких температурах, скорее количественное, чем качественное.
Термин полупроводники обычно понимают в узком смысле, т.е. как совокупность нескольких наиболее типичных групп веществ, полупроводниковые свойства которых проявляются уже при комнатных температурах (таблица 1).
Таблица 1
Элементы,
на основе которых создаются полупроводниковые материалы
| Элементы | А | |||||||
| Период | II | III | IY | Y | YI | YII | YII | |
|
В | II | Be | B 1,1 | C 5,2 | N | O | ||
| III | Al | Si 1,1 | P 1,6 | S 2,5 | Cl | |||
| IY | Ca | Ge 0,7 | As 1,2 | Se 1,7 | Br | |||
| Y | In | Sn 0,06 | Sb 0,12 | Te 0,36 | I 1,25 | Xe | ||
| YI | Pb | Bi | Po | At | ||||
Полупроводники (таблица 1.1.) представлены в виде ″чистых″ элементов (A, В) или в виде соединений, условно называемых AxBy. Цифрами отмечены значения важнейшего параметра полупроводниковых материалов – ширины запрещенной зоны (эВ) (см. далее).
1. Элементы IY группы Периодической системы - германий (Ge) и кремний (Si)
Атомы этих элементов, имея четыре валентных электрона, образуют кристаллическую решетку типа ″алмаз″ с ковалентной связью. Собственно углерод с решеткой типа ″алмаз″ также обладает полупроводниковыми свойствами, однако величина ширины энергии запрещенной зоны у него значительно больше, чем у германия и кремния, поэтому при комнатных температурах проводимость алмаза мала.
2.Алмазоподобные полупроводники
а) C оединения типа A III BV - cоединения элементов III группы (Al, Ga, In) с элементами V группы (P, As, Sb) -, например, GaAs, InSb, GaP, InP и т.п.
Атомы Ш группы имеют по три валентных электрона, а атомы V группы - по пять, таким образом, в соединении типа AIIIBV среднее число валентных электронов, приходящихся на один атом - четыре. В результате соединения элементов Ш и V групп образуется кристаллическая решетка типа алмаза, аналогично, например, германию, с той разницей, что ближайшими соседями атома АIII являются атомы ВV, и наоборот. За счет частичного перераспределения электронов, атомы А и В в такой структуре оказываются разноименно заряженными. Поэтому связи в кристаллах АIIIВV частично ковалентные, частично - ионные. Однако ковалентная связь в них преобладает и определяет их структуру, в результате чего данные кристаллы по многим свойствам являются аналогами Ge и Si.
б) Соединения типа А II ВVI - соединения элементов II и VI групп. К ним относятся соединения типа ZnTe, ZnSe, CdTe, CdS и другие. В этих соединениях на один атом также в среднем приходится по четыре валентных электрона, но ионная связь в них более выражена.
Последнее изменение этой страницы: 2019-04-20; Просмотров: 202; Нарушение авторского права страницы